

-
首页
-
关于我们
- 公司简介
- 公司动态
- 公司荣誉
-
产品与服务
- 热管
- 均温板
- 3D 均温板
- 热柱
- 散热模组
- 散热片
-
研发中心
- 研发团队
- 专利技术
-
制造能力与质量控制
-
应用领域
- 轨道交通
- 服务器
- 新能源光伏
- 新能源汽车
- 大数据中心
- 台式电脑
- 激光投影仪
- LED灯
-
联系我们


-
首页
-
关于我们
- 公司简介
- 公司动态
- 公司荣誉
-
产品与服务
- 热管
- 均温板
- 3D 均温板
- 热柱
- 散热模组
- 散热片
-
研发中心
- 研发团队
- 专利技术
-
制造能力与质量控制
-
应用领域
- 轨道交通
- 服务器
- 新能源光伏
- 新能源汽车
- 大数据中心
- 台式电脑
- 激光投影仪
- LED灯
-
联系我们
高功耗、高热流密度芯片的3DVC解决方案
高功耗、高热流密度芯片的3DVC解决方案
广州华钻电子科技有限公司 陈平
随着芯片制程技术的进步,芯片领域出现了一些新的趋势:
第一,芯片的功耗越来越高,从过去的165瓦逐渐过渡到500瓦,甚至向1000瓦发展;
第二,芯片的热流密度越来越高,由20瓦/平方厘米的热流密度已经发展到200瓦/平方厘米,未来向更高热流密度比如300瓦/平方厘米的方向发展;
第三,对于现有的框架,散热空间并没有增加,芯片温度要求也没有变化,因此同样的散热空间以前只需解热200瓦,现在需要解热500瓦,甚至更高,难度陡增;第四,更多的应用场景需要高功耗、高热流密度芯片,比如现在最火的人工智能机器人ChatGPT,需要天量的高性能GPU来担负其算力,未来越来越多的人工智能会涌现出来,这对芯片的热控提出了非常高的要求,无疑是高难度的挑战,必须有新的解热方案。
当散热空间不变或有限时,且芯片的功耗和热流密度在不断增加的情况下,最重要的是如何解决芯片的导热难题,增加其导热系数,降低其导热热阻。对于空冷来说,主要的导热手段有热管、热板、或者热板上叠加热管这三种方式,热管由于其蒸汽通道太小,毛细极限有限,传热功耗较小,热板由于其只能沿平面传热,应用受限,而热板上叠加热管的方式又显然比单一的热管或热板的导热要好很多,但由于热管叠加在热板上,多了一组蒸发热阻,对于更高功耗或更高热流密度的芯片还是无法满足其导热要求。如图1所示,3DVC只有一个蒸发热阻,蒸汽空间够大,完全可以满足高功耗或高热流密度芯片的导热要求。
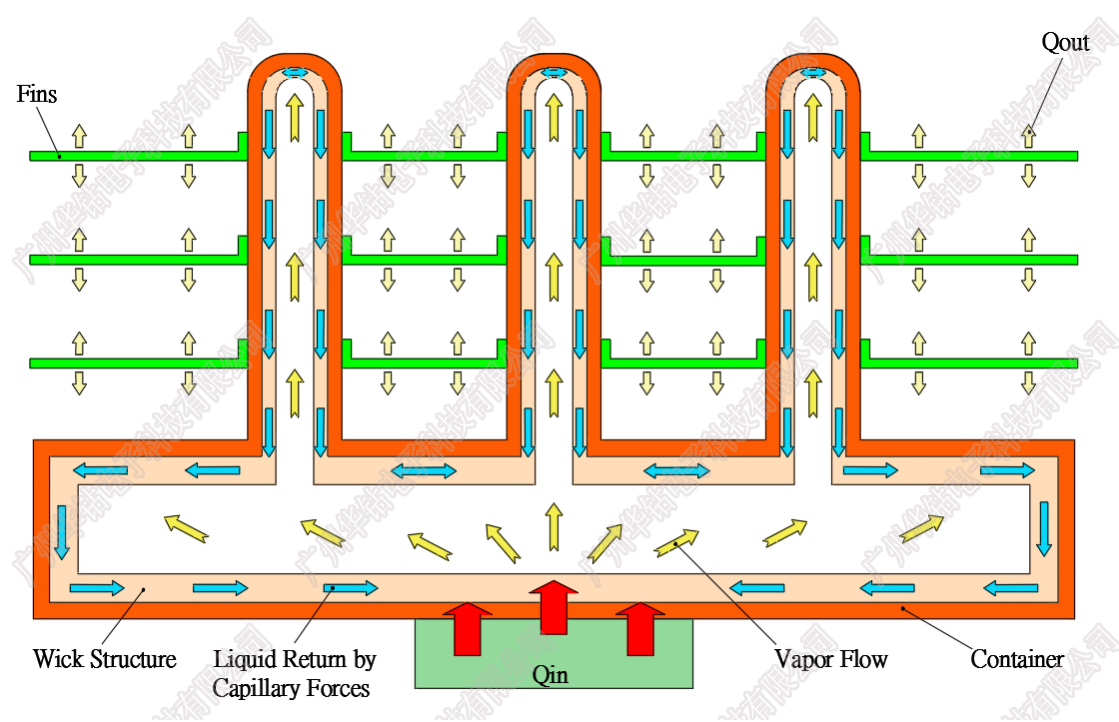
图1. 3DVC工作原理
3DVC由于其结构特点,具有非常多的优势:
第一,构造灵活,利用热管的结构特点实现3DVC向空间延展,尤其在狭小空间、不规则空间特别适用;
第二,蒸汽腔体空间大,将热管和均热板的蒸汽腔体贯通,使得蒸汽腔体体积增加,蒸汽能够直达热管尾端,降低均热板盖板到热管的热阻;
第三,热阻较低,相对均热板+热管叠加的方式,由于去掉了热管的蒸发热阻,只剩下均热板的蒸发热阻,3DVC的热阻明显降低,在高功率、高热流密度下的应用尤其明显,低风量下的3DVC导热更具竞争力,差异更大。
广州华钻电子科技有限公司(www.hzcooler.com)目前生产的3DVC结构分为两种结构,垂直式的和平行式的。

图2. 垂直式的3DVC

图3. 平行式的3DVC
转载请注明出处(www.hzcooler.com)
应用领域
一家自主知识产权,集散热方案设计,核心部件研发生产于一体的高新技术企业
Website:http://www.hzcooler.com
Address:广州市黄埔区科学城科丰路31号华南新材料创新园G4-501
E-mail:chenping@thermso.com

